Системы
Ионные источники
Ионные источники получили широкое распространение в технологии тонких пленок. Одним из главных достоинств ионно-лучевых технологий является разделение областей плазмообразования, ускорения ионов и объекта обработки. Это позволяет распылять металлы, диэлектрики и полупроводники без использования ВЧ мощности. В настоящее время в лаборатории разработано и эксплуатируются ионные источники различных типов. Многообразие разработанных ионных источников позволяет пользователю подобрать для конкретной операции источник с соответствующими параметрами формируемого пучка.
Одним из наиболее развитых направлений в области технологических генераторов ионных пучков в бывшем СССР и сейчас в Беларуси является разработка технологических ионных источников на основе ускорителей с анодным слоем и торцевых холловских ускорителей. В данных источниках ионизация рабочего газа производится электронам, намагниченными в поперечном магнитном поле. Ускорение ионов происходит в зоне разряда без нарушения квазинейтральности плазмы, что снимает ограничения на плотность отбираемого ионного тока.
В лаборатории ионно-плазменных систем и технологий разработан ряд ионно-лучевых устройств на основе ускорителя с анодным слоем и торцевого холловского ускорителя для технологии формирования тонких пленок: распыляющие ионные источники, ионные источники для ионно-ассистированного нанесения слоев, двухлучевые ионные источники.
В зависимости от формы и размеров подложки, требуемой производительности, конфигурации вакуумной камеры, свойств материала мишени и требуемых свойств наносимого покрытия предлагаются аксиальные, протяженные, и цилиндрические версии ионных источников с различной геометрией ионного пучка. Разработаны аксиальные ионные источники с распыляемой мишенью диаметром от 35 мм до 100 мм и протяженные ионные источники с длиной рабочей зоны до 100 см (40”). В распоряжении имеются как внутрикамерные, так и внешние (фланцевые) модели ионных источников. В зависимости от назначения ионного источника и условий эксплуатации в качестве источников магнитного поля используются как электромагниты (соленоиды), так и Sm-Co, Nd-Fe-B, Sr-Fe-O постоянные магниты. Магнитная система на постоянных магнитах чаще всего используется в случае внутрикамерного исполнения источника и для промышленных протяженных ионных источников. Применение соленоидов позволяет оптимизировать индукцию магнитного поля в канале ускорения и повысить эффективность формирования ионных пучков.
Разработанные ионные источники устройства имеют простую конструкцию, просты в применении и нечувствительны к загрязнению. Оригинальная конструкция фланцевого крепления и съемного мишенного блока ионного источника обеспечивает легкий доступ оператора для очистки ионных источников и смены мишеней. Это позволяет использовать данные устройства, как для исследований, так и в промышленности.
Плазменные источники электронов для нейтрализации ионных пучков
Области применения ионных источников несколько ограничиваются необходимостью использования достаточно сильноточных эмиттеров электронов. Так для торцевого холловского ускорителя мощный источник электронов необходим для поддержания процесса плазмообразования и компенсации пространственного заряда ионного пучка. Проблема компенсации потока ионов также возникает при формировании сфокусированных ионных пучков. Электрические поля, возникающие при транспортировке фокусируемого ионного пучка, могут достигать высоких значений, расфокусируя ионы. Как следствие, распространение сфокусированных ионных пучков сопровождается их расплыванием вследствие взаимного расталкивания ионов.
Также проблема возникновения неустойчивости разряда ионных источников отмечается в процессах ионно-лучевого распыления диэлектрических мишеней или реактивного ионно-лучевого распыления при нанесении диэлектрических слоев. Данная проблема связана с нескомпенсированностью ионного пучка и образованием поверхностного положительного заряда на поверхности мишени и растущей пленки.
При этом значительно ухудшается стабильность процесса и уменьшается скорость распыления. Кроме того поверхностный заряд может стать источником возникновения электрического пробоя диэлектрической пленки. Особенно это актуально при нанесении конденсаторных диэлектриков и оптических слоев.
Применение систем активной нейтрализации ионных пучков позволяет не только практически устранить нескомпенсированность ионных пучков, но и в некоторых случаях интенсифицировать процессы плазмообразования и диссоциации газов в процессах реактивного распыления.
Эффективная нейтрализация сфокусированных ионных пучков позволяет устранить электрические поля объемного заряда. В данном случае только ограничения, связанные с формированием плотной плазмы ограничивают размер пятна сфокусированного ионного пучка.
В настоящее время для нейтрализации ионных пучков ионных источников все более широкое применение получают плазменные источники электронов (ПИЭЛ), в которых эмиттером электронов служит газоразрядная плазма. В ПИЭЛ отбор электронов производится с границы плазмы, образованной в локализованном объеме. Уход электронов из плазмы восполняется электронной эмиссией с катода и ионизацией газа.
В технологии ионно-лучевого распыления и травления слоев с использованием ионных пучков предпочтительным является метод принудительной компенсации, который позволяет работать при более низких давлениях в камере, активно управлять процессом компенсации ионного пучка и потенциалом подложки. В данном методе электроны создаются источниками, расположенными вне области вакуумной транспортировки пучка. Электроны извлекаются путем принудительной экстракции или под действием положительного электрического поля, создаваемого ионным пучком, и в необходимом количестве “присоединяются” к ионам (смотрите рисунок). В результате нейтрализованный пучок имеет плотность электронов приблизительно равную плотности пучка.
В лаборатории разработаны плазменные источники электронов на основе магнетронного разряда, в котором используется холловский ток электронов в скрещенных ExH полях. Разряд в скрещенных ExH полях является эффективным источником электронов, которые могут быть применены для компенсации пространственного заряда ионного источника. Отсутствие накальных элементов позволяет значительно повысить ресурс работы нейтрализатора при работе в атмосфере инертных и активных газов и время межсервисного обслуживания.
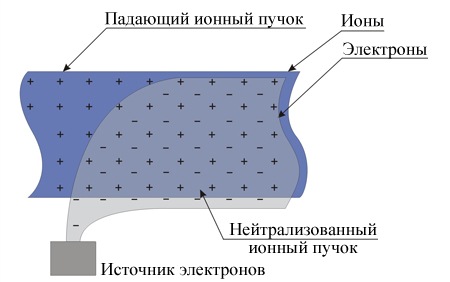
Магнетронные распылительные системы
Метод магнетронного распыления получил быстрое развитие в последнее десятилетие, где он установился как вариант процесса нанесения широкого диапазона важных для промышленности покрытий. Примерами являются твердые, износостойкие покрытия, антикоррозионные, декоративные покрытия и покрытия со специфическими оптическими, или электрическими свойствами.
Увеличение усилий в области разработки магнетронных распылительных систем обусловлено растущим спросом на высококачественные функциональные покрытия в разнообразных секторах рынка. Пленки, полученные методом магнетронного распыления, теперь во многих случаях по свойствам превосходят пленки нанесенные другим методами физического осаждения (PVD). Кроме того метод обладает высокой производительностью и по сравнению с другими методами могут быть получены значительно более толстые пленки. Следует отметить, что в настоящее время магнетронное распыление составляет около 90 % всего рынка распылительного оборудования.
В лаборатории ионно-плазменных систем и технологий проводятся работы и накоплен большой опыт в области разработки и исследования магнетронных распылительных систем. В лаборатории, начиная с 1994 года, создана широкая гамма моделей магнетронов, специально разработанных для научных исследований и промышленного применения. В зависимости от формы и размеров подложки, требуемой производительности, конфигурации вакуумной камеры, свойств материала мишени и требуемых свойств наносимого покрытия предлагаются планарные аксиальные, прямоугольные, протяженные, цилиндрические версии магнетронов. В распоряжении имеются как внутрикамерные, так и внешние (фланцевые) модели магнетронов. Данные МРС могут функционировать с DC, импульсными MF, биполярными AC и RF источниками питания.
В зависимости от назначения магнетрона разработаны аксиальные магнетроны с размером мишени от 2.5 см (1”) до 17.0 см (7”) и магнетроны протяженного типа серии MSPR с размером мишени до 100 см (40”). Данные распылительные системы имеют оригинальную конструкцию магнитной системы, что позволяет создавать магнетроны со сбалансированной и несбалансированной (I и II типа) конфигурацией магнитного поля. Для количественной оценки степени несбалансированности нами введены понятия коэффициентов несбалансированности и геометрической несбалансированности МРС, которые характеризуют конфигурацию магнитного поля и, следовательно, минимальное рабочее давление, величину ионного тока на подложку и коэффициент использования материала мишени. Для оперативного изменения уровня несбалансированности разработаны магнетронные распылительные системы с дополнительным соленоидом (серия MAC).
Магнитные системы магнетронов выполняются на Sm-Co, Nd-Fe-B, Sr-Fe-O постоянных магнитах и электромагнитах. В магнетронах с магнитной системой на ферритовых магнитах используется непосредственное охлаждение магнитов и мембранное охлаждение мишени. Для повышения эффективности охлаждения возможно использование непосредственного охлаждения мишени. В магнетронах на металлических магнитах магнитная система размещается в медном корпусе катода и изолирована от проточной воды, что гарантирует постоянство характеристик магнитов в течение всего срока эксплуатации.
Применение интегрированных систем газораспределения позволяет оптимизировать неравномерность скорости распыления, снизить эффект ассиметричности вакуумной откачки и повысить стабильность разряда при проведении процессов реактивного распыления. Новая конструкция магнетронных распылительных систем обеспечивает легкий доступ оператора для смены мишеней и очистки магнетрона.
Одним из направлений деятельности лаборатории является разработка высоковакуумных магнетронных распылительных систем. При снижении рабочего давления ниже уровня 0.1 Па значительно изменяются физические условия формирования разряда магнетрона и конденсации распыленного потока. При этом возможно формирование компонентных слоев методом реактивного магнетронного распыления без использования систем управления парциальным давлением реактивного газа. Кроме того, снижение минимального рабочего давления магнетрона позволяет совместить работу магнетронных распылительных систем с ионными источниками и реализовать методы совместного распыления и ионно-ассистированного магнетронного распыления (IBAM).

